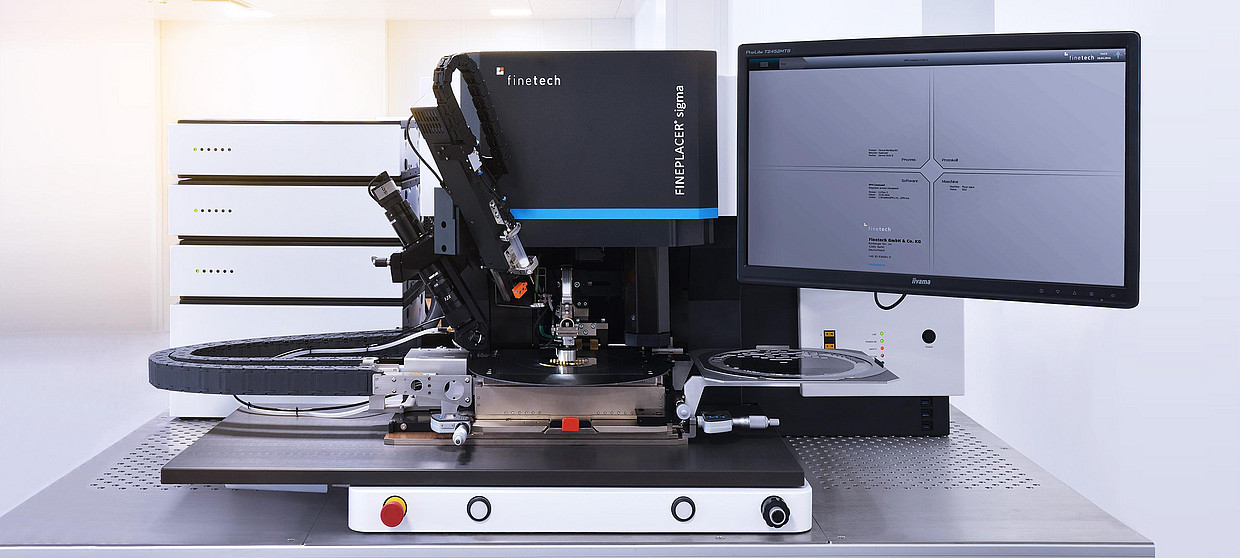
Unrivaled Flexibility for Research & Prototyping
Advanced Sub-Micron Bonder
Der FINEPLACER® sigma vereint eine Platziergenauigkeit besser 1 µm, eine großzügige Arbeitsfläche bis 450 x 150 mm sowie Bondkräfte bis 1000 N.
Damit eignet sich das System ideal für hochgenaues Die Bonding und FlipChip-Anwendungen auf Chip- und Waferebene, beispielsweise bei der Montage komplexer 2.5D und 3D Packages, von FPA (z.B. Bildsensoren) oder MEMS/MOEMS.
Um die Genauigkeit über große Flächen auf das Substrat zu bringen, hat Finetech das neue Vision Alignment System FPXvisionTM entwickelt. Damit werden selbst feinste Strukturen über das gesamte Objektfeld hochaufgelöst dargestellt. Erstmals stehen auch Bilderkennungs-Verfahren in einem manuellem Die Bonder zur Verfügung. Als zukunftssichere Montage- und Entwicklungsplattform bietet der FINEPLACER® sigma somit nahezu unbegrenzte Einsatzmöglichkeiten.


Ihr Kontakt
- Finetech GmbH & Co. KG
- Head of Sales Europe
- +4930936681300
- finetech_thomas
Kontaktieren Sie uns
Eckdaten*
- Großer Arbeitsbereich
- Reproduzierbare Platziergenauigkeit im Submikrometerbereich
- Bilderkennung für software-verifiziertes Ausrichten
- Große Bandbreite an unterstützten Bauteilgrößen
- UHD Vision Alignment System mit FPXvisionTM
- Modulare Maschinenplattform ermöglicht Vor-Ort-Nachrüstung über die gesamte Nutzungsdauer
- Breites Spektrum unterstützter Bauteilpräsentationen (Wafer, Waffel Pack, Gel-Pak®)
- Synchronisierte Steuerung aller prozessbezogenen Parameter
- Kompatible Prozessmodule über alle Finetech-Bondplattformen hinweg
- Individuell konfigurierbar durch Prozessmodule
- Sehr kleine Bondkraftbereiche einstellbar
- Umfangreiche Daten-/Medienprotokollierung und Berichtsfunktion
- Breites Spektrum an kontrollierten Bondkräften
- In-situ-Prozessbeobachtung in HD
- Vollzugriff auf den Prozess und einfache visuelle Programmierung mit Touchscreen
- Zahlreiche unterstützte Verbindungstechnologien (Kleben, Löten, Thermokompression, Ultraschall)
- 3-Farben-LED-Beleuchtung
- Sequenzsteuerung mit vordefinierten Parametern
Video
Mit dem Aufruf dieses Elements erklären Sie sich einverstanden, dass Ihre Daten an externe Dienste (https://www.youtube-nocookie.com) übermittelt werden und dass Sie unsere Datenschutzerklärung gelesen haben.
Applikationen & Technologien
Dank einer breiten Palette unterstützter Technologien und Applikationen meistern unsere Die-Bonder nahezu jede Herausforderung. Falls sich die Marktanforderungen ändern und neue Aufgaben hinzukommen, sorgt die modulare Hard- und Softwarearchitektur für maximale technologische Vielfalt über die gesamte Nutzungsdauer.
- Micro-optical bench assembly
- IR detector assembly
- Gas pressure sensor assembly
- VCSEL/photo diode (array) assembly
- Visual image sensor assembly
- Generic MEMS assembly
- Micro optics assembly
- Single photon detector assembly
- Ultrasonic transceiver assembly
- Laser diode assembly
- µLED (array) assembly
- Laser diode bar assembly
- High-power laser module assembly
- Acceleration sensor assembly
- Generic MOEMS assembly
- Ink jet print head assembly
- Mechanical assembly
- X-Ray detector assembly
- Optical sub assembly (TOSA/ROSA)
- E-beam module assembly
- Mechanical assembly
Funktionen - Module - Erweiterungen
Unsere Die-Bonder sind so individuell wie die Anforderungen unserer Kunden und bieten vielfältige Konfigurationsmöglichkeiten. Neben zahlreichen Grundfunktionen, die standardmäßig zum Funktionsumfang gehören, stehen für jedes System eine Auswahl von Prozessmodulen zur Verfügung, welche das Applikationsspektrum erweitern. Jederzeit nachrüstbar, ermöglichen sie direkt oder als Bestandteil eines Modulpakets zusätzliche Verbindungstechnologien und Prozesse. Eine Reihe von Funktionserweiterungen und weiteres Zubehör erleichtern die tägliche Arbeit mit dem Die-Bonder und helfen dabei, bestimmte Technologie- und Prozessabläufe noch effizienter zu gestalten.
- Abstandsmodul
Zum präzisen Einstellen eines Abstands zwischen Komponente und Substrat.
- Aushubstation
Ausheben von Objekten aus Fördereinheiten in eine Bearbeitungsposition.
- Automatischer Toolwechsler
Ermöglicht die Nutzung mehrerer Tools mit demselben Toolhalter. Automatischer Toolwechsel im Prozess.
- Automatischer Toolwechsler
Ermöglicht die Nutzung mehrerer Tools mit demselben Toolhalter. Automatischer Toolwechsel im Prozess.
- Automatisches Rakelwerk
Motorisches Rakelwerk für viskose Medien wie Flussmittel oder Klebstoff. Geeignet für die Verwendung mit Stempel-Werkzeugen oder zum direkten Eintauchen von Chips verschiedener Größen. Es lassen sich unterschiedliche Wannentiefen einstellen.
- Barcode-Reader "SmartIdent"
Erweitert die Funktionalität der Betriebssoftware. Ermöglicht eine schnelle und sichere Identifizierung jeder Leiterplatte anhand ihrer eindeutigen Barcode-Etiketten.
- Bauteilpräsentation
Ermöglicht die Präsentation von Komponenten über Gel-Pak®, VR-Trays, Wafer-Packs oder Tape-Haltern sowie den Einsatz von Dipping-Trays und Reinigungseinheiten.
- Bilderkennung
Software-Tool für die Erkennung verschiedener Ausrichtmarken. Dient der Steuerung von Position und Ausrichtung von Bauteil und Substrat.
- Bondkraft-Modul (automatisch)
Erweitert den vorhandenen Bondkraftbereich und erlaubt softwaregesteuerte Kräfte im Prozess.
- Bondkraftmodul (manuell)
Stellt verschiedene Bondkraftbereiche zur Verfügung und ermöglicht die mechanische Einstellung unterschiedlicher Prozesskräfte.
- Chip-Ausstech-Modul
Ermöglicht die Aufnahme von Komponenten mit dem Platzierarm direkt von der Folie. Unterstützt werden Sägeringe und Waferrahmen.
- Chip-Heizmodul
Direkter Wärmeeintrag von oben in den Chip mit Hilfe eines bauteilspezifischen Tooldesigns, z.B. genutzt für Thermokompression, ACA und andere Klebeprozesse.
- Die Eject Module with Carousel
Ermöglicht die Aufnahme von Komponenten mit dem Platzierarm direkt von der Folie unter Verwendung verschiedener Ausstechtwerkeuge. Unterstützt werden Sägeringe und Waferrahmen.
- Die-Flip-Modul
Erlaubt das Wenden von Dies vor dem Bonden, falls diese face-down montiert werden sollen.
- Direct-Component-Printing-Modul
Lotpastenauftrag leicht gemacht durch Direktdruck auf die Komponente. | Die Universallösung für die Nacharbeit von QFN, SON und MLF Komponenten.
- Dispens-Modul
Integration von Dispenser-Systemen zum Auftragen von Kleber, Flussmittel, Lotpaste oder anderen pastösen Materialien. Unterstützung von verschiedenen Typen, wie Zeit-Druck-, Volumen- oder Jet-Dispensern.
- Dual-Kamera-Optik
Die zusätzliche Kamera ermöglicht zusammen mit der Hauptkamera zwei Objektfeldgrößen ohne Zoom oder unterschiedliche Objektfeldpositionen. Verbessert die Darstellbarkeit von großen Objekten und beschleuningt so den Arbeitsfluss.
- FPXvisionTM
Stellt eine hohe Auflösung bei allen Vergrößerungen sicher.
- Flip-Chip-Test-Modul
Über einen "Known Good Die"-Test können Chips vor dem Bonden geprüft werden.
- Formgenerator
Softwareerweiterung für die Erstellung und Anzeige virtueller Formen im Kamerabild zur Unterstützung von relativen und Face-up-Ausrichtprozessen.
- Formic-Acid-Modul
Dient der Generierung einer inerten oder reaktiven (CH2O2) Atmosphäre innerhalb einer geschützten Kammer. Nutzung zur Reduzierung und Verhinderung von Oxiden während des eutektischen oder Indium-Bondens. Add-on für Substrat-Heizmodule.
- HEPA-Filter
Integrierter HEPA-Filter zur Reinigung der Atmosphäre im geschlossenen System. Ermöglicht Reinraumbedingungen und verringert Partikelbelastung.
- Handling-Modul
Ermöglicht die Handhabung eines Substrats oder Bauelements unabhängig vom Bondwerkzeug.
- Hochauflösende Optik
Ermöglicht die Verwendung verschiedener achromatischer Linsen zur Anpassung des Bildfeldes und der optischen Auflösung.
- Höhenscanner (3D-Kamera)
Zum Ermitteln von Höhen, Längen und Koordinaten an zu bearbeitenden Objekten durch Bilderkennung (RGB-Beleuchtung/ Koaxial Beleuchtung).
- Höhenscanner (Autofokus)
Ermöglicht die automatische Scharfstellung von Komponente und Substrat sowie Höhenmessungen.
- Höhensensor (LASER)
Erlaubt die Höhenmessung mittels Laser-Triangulation.
- Höhensensor (mechanisch)
Zum Ermitteln von Höhen, Längen und Koordinaten an zu bearbeitenden Objekten durch mechanische Wegmessung.
- I/O Lift System
Ermöglicht automatisches Be- und Entladen von Substraten oder Booten aus/in Magazine(n).
- I/O Panel-Handling-System
Ermöglicht das automatische Be- und Entladen von größeren Substraten (Panels).
- ID Code Leser
Ermöglicht das Einlesen verschiedener ID Codes, wie Barcodes, 2D-Codes und RFIDs.
- Indexer / Förderband
Dient der automatischen Be- und Entladung von Substraten. Weitenverstellbar für unterschiedliche Substratbreiten.
- Kamera-Modul (3D)
Zum Ermitteln von Raumkoordinaten an zu bearbeitenden Objekten mittels Bilderkennung (RGB-Beleuchtung).
- Kamera-Modul (aufwärts blickend)
Zum Ermitteln von Flächenkoordinaten an der Unterseite von aufgenommenen Objekten mittels Bilderkennung (RGB/Koaxial Beleuchtung).
- Kamera-Y-Verschiebung
Ermöglicht die Verschiebung des Bildfeldes in Y-Richtung.
- Laser-Heizmodul
Ultraschnelle Heizzyklen mit Hilfe einer integrierten Hochleistungslaser-Quelle.
- Laser-Zündmodul
Aktivieren / Zünden von reaktiven Materialien wie z.B. Nanofoils mittels Laser-Impuls.
- Lotabsaug-Modul
Alles weg in nur einem Durchlauf. | Erlaubt die präzise Restlotentfernung in inerter Atmosphäre*. Das aufgeschmolzene Lot wird dank kraftvoller Vakuumdüsen ganz einfach vom Board gesaugt. Pads und Lötstopplack werden optimal geschützt.
- Magazin- & Gurt-Zuführung
Zuführung/Ausschleusen von Objekten zur automatischen Abarbeitung in größeren Stückzahlen auf minimaler Präsentationsfläche.
- Manuelle Tauch-Einheit
Manuelle Rakel-Einheit für Medien wie Klebstoffe oder Flussmittel. Geeignet für die Verwendung mit Stempel-Werkzeugen oder zum direkten Eintauchen von Chips verschiedener Größen. Mit unterschiedlicher oder einstellbarer Filmdicke.
- Maskengenerator "Skalierend"
Softwareerweiterung zur Erstellung und Projektion virtueller Masken um Ausrichtprozesse zu vereinfachen. Diese Masken können maßstabsgetreu aus mehreren Objekten kombiniert werden.
- Motorischer Z-Tisch
Positioniertisch mit motorischem Z-Hub zur automatischen Anpassung der Arbeitshöhe. Die Einstellung in X und Y erfolgt manuell über Mikrometerschrauben.
- Motorisierte Nick- und Rollbewegung
Kippeinheit mit motorischer Winkelverstellung in den Achsen Phi(X) und Phi(Y). Diese Nick- und Rollbewegung kann für das Parallelstellen oder für das Bonden in bestimmten Winkellagen verwendet werden.
- Optikverschiebung
Ermöglicht das Anfahren definierter Kamerapositionen entlang der X-Achse des Optiksystems. Hilfreich für das Ausrichten großer Bauteile mit maximaler Vergrößerung.
- Overlay Vision Alignment System (VAS) mit festem Strahlteiler
Vision-Alignment-System mit einer Kamera und ortsfestem Strahlteiler für das einfache und unmittelbare Ausrichten der Fügepartner.
- Plasma-Reinigung
Vorbereiten von Montageoberflächen mittels atmosphärischem Plasma zur besseren Benetzung bei Fügeprozessen.
- Programmierbarer Waferwechsler mit Kassettenlift
Zur Aufnahme von Kassetten für 300 mm Wafer. Programmierbare Geschwindigkeit und Slots.
- Prozessgas-Modul
Dient der Generierung einer inerten oder reaktiven (H2N2) Atmosphäre innerhalb einer geschützten Kammer oder am Werkzeug. Nutzung zur Reduzierung und Verhinderung von Oxiden während des Lötens oder Bondens.
- Prozessgasauswahl-Modul
Erweitert die Prozessgasfunktion um die programmierbare Umschaltung von zwei unterschiedlichen Gasen.
- Prozessvideo-Modul
Ermöglicht die Live-Prozessbeobachtung innerhalb des Arbeitsbereichs.
- Präzisionswaage
SPC (Statistische Prozesskontrolle) für Dispensmengen im automatischen Prozessablauf.
- Scrubbing-Modul
Verbessert das Benetzungsverhalten der zu bondenden Oberflächen und verringert Lunker. Oxidschichten werden durch einen niederfrequenten mechanischen Schallprozess aufgebrochen.
- Substrat-Halter
Unbeheizte Trägerplatte mit substratspezifischer Fixierung (z.B. Vakuumstrukturen).
- Substrat-Heizmodul
Direkter Wärmeeintrag von unten, um Substrate im Prozess auf Temperatur zu bringen. Substratspezifische Fixierungen verfügbar. Optional mit Prozessgas-Integration. Genutzt z.B. für Thermokompression, Thermosonic- und Klebeprozesse.
- Target Finder
Ein kleiner roter Punkt macht vieles leichter. | Ermöglicht die schnelle Grobausrichtung des Positioniertisches zum Tool mit Hilfe eines Laserspots.
Mehr erfahren (PDF, 0.3 MB) - Tool-Tip-Wechselmodul
Ermöglicht die Nutzung mehrerer Tools mit demselben Toolhalter.
- Traceability-Modul
Automatische Erfassung aller prozessrelevanten Parameter (z.B. Temperatur, Kraft, etc.) sowie Details damit im Zusammenhang stehender Komponenten (z.B. Seriennummern).
- UV-Aushärte-Modul
Stellt ultraviolettes LED-Licht für Klebeprozesse ohne Wärmeeinfluss zur Verfügung. Die UV Quelle kann entweder an einen Werkzeug befestigt oder am Substrathalter angebracht werden (verschiedene Wellenlängen verfügbar).
- Ultraschall-Modul
Ermöglicht Thermosonic- und Ultraschall-Bonden. Über laterale Schwingungen eines Ultraschall-Transducers wird mechanische Energie auf die Komponente übertragen, während sie sich im Kontakt mit dem Substrat befindet.
- Vakuumkammer-Modul
Ermöglicht Bondprozesse innerhalb einer im System integrierten Vakuumkammer. Keine zusätzlichen Handling-Schritte erforderlich, volle Softwarekontrolle.
- Wafer-Heizmodul
Substrat-Heizmodul speziell für große Wafer. Besonders gleichmäßige Wärmeverteilung bei Chip-to-Chip oder Chip-to-Wafer-Anwendungen.
- Wafertisch
Positioniert den Wafer automatisch über dem Die-Ejektor.
- Waferwechsler
Zur Aufnahme von Kassetten für 300 mm Wafer. Programmierbare Geschwindigkeit und bis zu 24 Slots.
- Zoom-Optik
Anpassung der Bildfeldgröße des Vision Alignment Systems, um Komponenten und Substrate optimal visuell darzustellen.
Technical Paper

Focal Plane Array Bonding

Eutektisches Bonden mit Au/Sn