Video Library
Bonding Videos
This growing selection of Finetech product and application videos gives an overview of different use cases for micro assembly systems and introduces you to some of the machines’ functions and working principles.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

Reactive Soldering with Laser Activation
Finetech’s Laser Activation Module is used to activate or ignite reactive materials such as preforms or nanofoils by a laser pulse. With that short pulse of less than one second, the ignition temperature is reached and a rapid reaction will heat the solder layers on the preform. Additional cooling is not required.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

FINEPLACER® pico 2 - Multi-Purpose Manual Die Bonder for R&D and Lab
The FINEPLACER® pico 2 is a multi-purpose, manual die bonder with placement accuracy down to 3 µm. Quick to set up and easy to operate, the system is ideal for fast and flexible product development and prototyping in R&D labs and universities.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

FINEPLACER® femtoblu - Chip-on-Submount (CoS) Assembly
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.
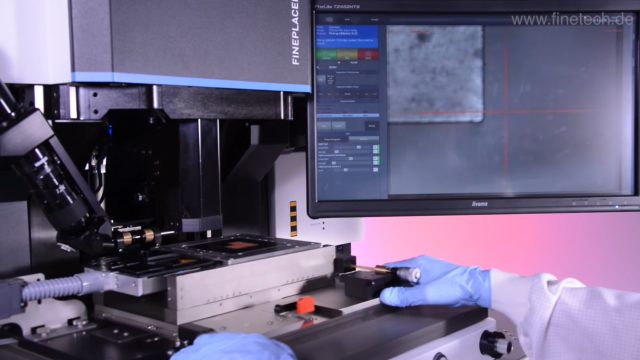
Sub-Micron Sensor Assembly
Bonding of a 20x20mm sensor containing 143,616 bumps and 50 micron pitch. Pickup process uses controlled force and a parallelism control tool.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.
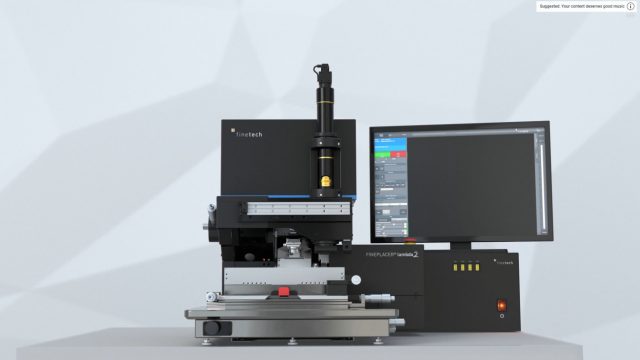
New FINEPLACER® lambda 2 product introduction
The all-new FINEPLACER® lambda 2 builds on its acclaimed predecessor to set new standards in precision die attach and advanced chip packaging for opto-electronic assemblies and more.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

Face Down VCSEL Assembly on Transceiver Modules
Thermo-compression bonding process for VCSEL to transceiver substrate assembly. Precise placement is achieved by aligning the VCSEL eye to the substrate aperture.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.
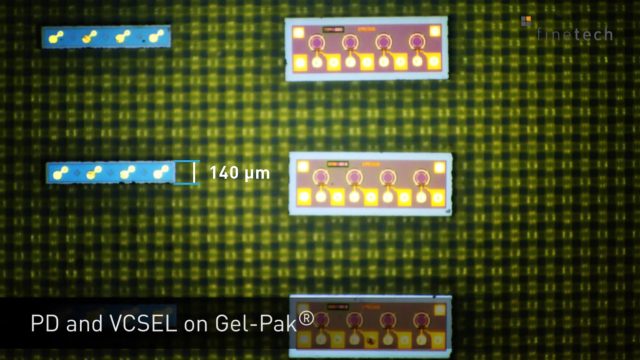
Face-up Assembly of VCSEL and PD
Bonding of VSCEL and Photo Diode using a sophisticated reference tool. Process involves vision control of placement. Silver epoxy and curing are used in the application.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.
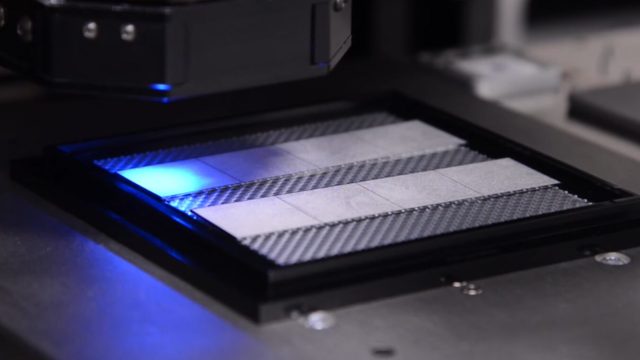
FINEPLACER® femto 2 - High Accuracy Automatic Die Bonder
The FINEPLACER® femto 2 bonder offers a precise large working stage, large device 3D handling, extended FOV, ultra HD vision system, and multicolor illumination. System features include a process gas enclosure, low and high bond force, and a local cleanroom environment.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

FINEPLACER® femto 2 - Tacking, Bump Bonding
Population of a sensor substrate with several readout chips. Integrated oven process for preparation (bump forming with formic acid) and connection of the fine-pitch bump arrays via tack bonding (indium). Followed by a global reflow process in inert atmosphere.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

FINEPLACER® femto 2 - Die Flipping Unit
Integrated die flip module automatically flips chips of various sizes and thickness. Can be used for chips that are presented with the bond side facing upward. Interchangeable platforms of the unit allow for component-specific adaptation.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

FINEPLACER® femto 2 - Handling & Dispensing Module
Multilevel chip placement application with 5 micron accuracy and auto alignment. Sorting and assistance processes can also be supported. The handling module picks up die with controlled force, rotates and places the device. The dispenser module allows the application of glue and paste.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

FINEPLACER® femto 2 - 3D Joystick
The 3D joystick allows fast, easy machine operation – a helpful tool when combined with the vision system and measuring function. Switching over from automatic to manual mode is possible at any time. Perfect bonding results with no programming effort.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

Au-Au Thermosonic Flip Chip Bonding
Au on Au bonding process combines low temperature heat and moderate force aided by ultrasonic motion in the 60 – 100 kHz range – suitable for low to medium I/O count devices. Finetech systems provide optimized field of view for alignment and visual inspection in-situ.
Rework Videos
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

BGA Rework
Desoldering, soldering, residual solder removal on flat panel TV PCB.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

CSP Rework on Mobile Phones
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.
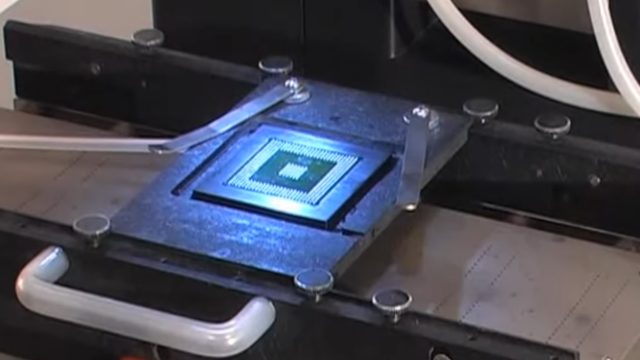
BGA Reballing
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

Rework of GPU
Typical process steps of CPU/GPU rework. This includes pre-inspection, board preparation, profiling de-soldering the component, residual solder removal, reballing, special processes such as solder paste printing or dispensing, soldering the new/reworked component and finally the follow-up optical inspection.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

Contactless Residual Solder Removal
Contactless solder removal (site dressing) showing alignment of tool and component, application of flux and the removal process.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

01005 Small Passives Rework
Process camera video: desoldering of 01005 small passive with small gap.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.
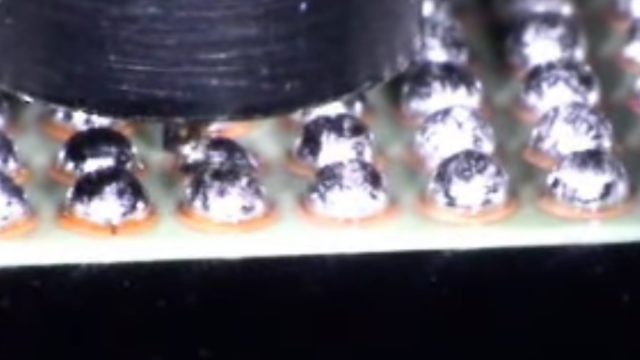
Single Ball Reballing
Process camera video: removing a solder ball bridge in a BGA
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

QFN desoldering
Process camera video: removing a QFN component.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

PoP Rework
Process camera video: Active clamping soldering head for rework of PoP stacked components.
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

QFN Rework
Direct Component Printing of QFN or MLF. No additional reflow process for solder transfer onto the component necessary. Minimum heat load to component. QFN rework in OEM quality!
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

µBGA Desoldering
Process camera video: Desoldering a µBGA component.
